
 De acordo com Patently Apple , a TSMC está trabalhando em uma nova plataforma de embalagens chamada 3DFabric. Durante o verão, o CEO da fundição, C.C. Wei disse:”Estamos trabalhando com vários clientes no 3DFabric para habilitar a arquitetura de chips.”A maior fundição independente do mundo agora diz que seus primeiros clientes empregando a nova tecnologia 3DFabric incluirão Apple, AMD, MediaTek, Xilinx, NXP e Qualcomm.
De acordo com Patently Apple , a TSMC está trabalhando em uma nova plataforma de embalagens chamada 3DFabric. Durante o verão, o CEO da fundição, C.C. Wei disse:”Estamos trabalhando com vários clientes no 3DFabric para habilitar a arquitetura de chips.”A maior fundição independente do mundo agora diz que seus primeiros clientes empregando a nova tecnologia 3DFabric incluirão Apple, AMD, MediaTek, Xilinx, NXP e Qualcomm.
A nova plataforma 3DFabric Packaging da TSMC pode estrear no iPhone 14
Com a tecnologia 3DFabric, os clientes da TSMC podem usar chips que são chips menores usados para criar um circuito integrado maior. Essa tecnologia pode acelerar o tempo de colocação no mercado de uma nova tecnologia, pois essa plataforma permite que os clientes continuem a reutilizar partes do componente que não mudam. E de acordo com a TSMC,”3DFabric permite a integração de chips interconectados de alta densidade em um módulo empacotado, oferecendo largura de banda, latência e eficiência de energia aprimoradas.”A TSMC lançará a plataforma 3DFabric Packaging assim que começar a enviar chips de 3nm. A TSMC deveria estar fabricando o chipset Apple A16 Bionic usando o nó de processo 3nm. Mas no mês passado a empresa anunciou um atraso devido às complexidades de construir um chip neste nó de processo e o A16 Bionic será feito usando o nó de processo de 4 nm. 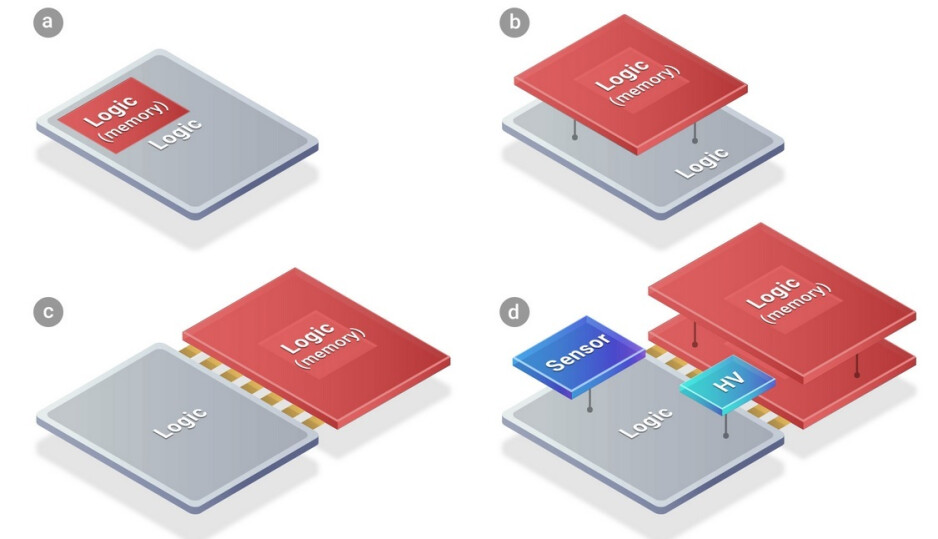
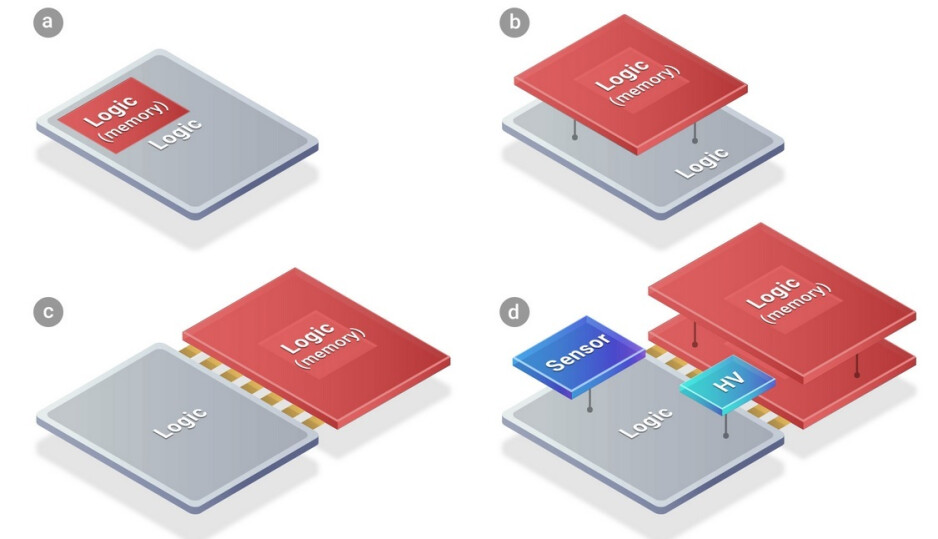
Os diagramas mostram SoC (A) típico seguido por SoICs usando chips (B, C, D)
Como resultado, não é Não está claro se veremos a plataforma 3DFabric Packaging usada no iPhone 14, embora o relatório da Patently Apple diga que”os iPhones de próxima geração da Apple em 2022 provavelmente usarão a plataforma 3D Fabric da TSMC.”O relatório acrescenta que, com a plataforma, muitas funções de IA, novos tipos de memória e chips integrados serão combinados. A TSMC deve testar a plataforma este ano em suas instalações em Zhunan e Nanke, com produção em massa programada para o segundo semestre de 2022.
A nova plataforma de embalagem da TSMC adota uma abordagem modular semelhante ao Lego usando chiplets
Se isso soa como algum tipo de solução modular para empacotamento, é. Em um vídeo que a TSMC produziu para mostrar a nova plataforma, as crianças estão brincando com blocos de Lego, que é o brinquedo modular definitivo. Liao Dedui, vice-gerente geral de serviços e tecnologia de embalagem avançada da TSMC, diz que o 3DFabric reúne tecnologias de embalagem e teste avançadas.
O blog da TSMC discute tecnologias de back-end, como Chip-on-Wafer (CoW) e Wafer-empilhamento de dados on-Wafer (WoW). Isso permite o empilhamento 3D de matrizes semelhantes e diferentes que podem ser usadas para fornecer mais poder de computação, aumentando o número de núcleos de computador. Ele também fornece mais memória e largura de banda maior, graças à memória empilhada, e também melhora o fornecimento de energia.
Este ano, a Apple está usando o 5nm A15 Bionic no recém-lançado iPhone 13 linha. Enquanto 15 bilhões de transistores são encontrados em cada chip A15 Bionic (até 27% dos 11,8 bilhões dentro do A14 Bionic), a densidade do transistor viu uma melhoria muito menor. Esta métrica mede o número de transistores em um mm quadrado e aumentou menos de 1% de 134,09 milhões no A14 Bionic para 135,14 milhões no novo chipset.
A Apple aparentemente decidiu gastar dinheiro para melhorar o desempenho gráfico em vez do CPU. A empresa viu alguns de seus melhores desenvolvedores de chips deixarem a Apple, o que pode ser responsável pelas melhorias impressionantes da CPU ano após ano. Embora a Apple geralmente goste de comparar novos componentes com os usados nos modelos do ano anterior, este ano as comparações foram feitas”contra a concorrência”e essas empresas (como Samsung e Qualcomm) não enviarão seus chips de próxima geração até chegamos mais perto do final do ano.
Se a TSMC for forçada a enviar um A16 Bionic de 4 nm em vez de um feito usando o nó de processo de 3 nm conforme planejado originalmente, haverá algumas repercussões, incluindo aumentos menores no desempenho e energia-consumo. Tanto a TSMC quanto a Samsung têm roteiros que os levam a 2 nm, embora possa haver mais obstáculos à medida que as fundições começarem a lidar com processos ainda mais complexos e avançados.
